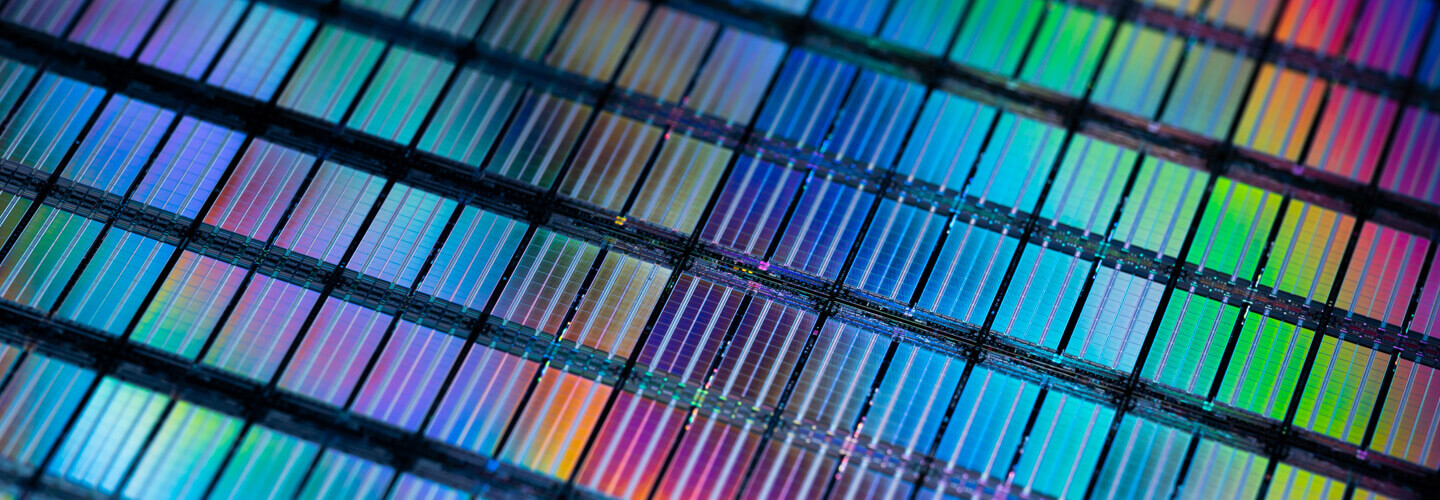
Panel Level Packaging—Ultra C vac-p Flux Cleaning Tool

Superior Flux Clean for Advanced Panel-Level Packaging
The Ultra C vac-p flux cleaning tool for fan-out panel-level packaging (FOPLP) is built on the legacy of ACM’s superior wafer cleaning equipment for fan-out wafer-level packaging (FOWLP) and high-bandwidth memory (HBM) processes. The Ultra C vac-p addresses critical steps in the advanced packaging process, particularly the removal of flux residue before underfilling, which is essential for eliminating voids, offering strong benefits for FOPLP, chiplets, and 2.5D/3D structures.
Traditional cleaning methods often fail with small bump pitches (<40 µm) and large chip sizes due to surface tension and limited liquid penetration. The vacuum technology in ACM’s Ultra C vac-p flux ensures the cleaning liquid thoroughly reaches all gaps, even in large panel substrates where traditional methods fall short. Combined with ACM’s proprietary IPA drying technology, this comprehensive cleaning process prevents residues that could impair device performance. The tool is capable of handling panels sized 510 x 515 mm2 and 600 x 600 mm2 while effectively managing cover warpages up to 7 mm.
Major Benefits
- Utilizes vacuum technology to efficiently remove flux residues from structures with bump pitches and standoff height <20 µm.
- Can be configured for various sizes and larger die quantities.
- Vacuum technology ensures good chemical penetration and complete cleaning of all structures.
Equipment Specifications
- Can handle 510 x 515 mm2 and 600 x 600 mm2 organic and glass substrate panels
- Configuration of 2 load ports
- Alignment and CCD edge inspection capability
- Able to use SAPS, hot IDW with high-pressure DIW under vacuum
- MTBF: 500 hours
- Uptime: 95%
- Panel breakage: <1/50,000
- Warpage: ≤10 mm

Contact Us
Looking for spare parts and customer support for your ACM Research Systems?
